當前AI快速發展對數據處理提出了更高的要求,先進封裝工藝越來越被視為實現芯片更高性能的途徑,在超越摩爾時代至關重要,美國加碼先進封裝,表明其已經成為技術競爭新的戰場。
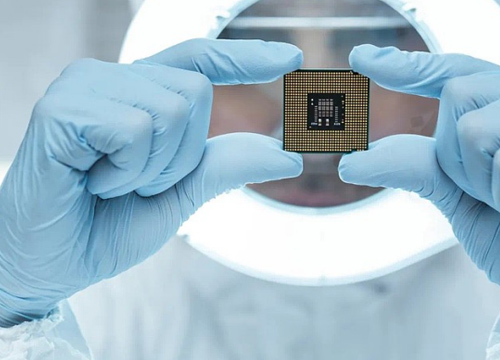
小芯片和混合鍵合開辟新領域
先進封裝已成為半導體創新、增強功能、性能和成本效益的關鍵。臺積電、英特爾和三星等大公司正在采用小芯片和異構集成策略,利用先進封裝技術以及前端擴展工作。
Chiplet 方法將 SoC 芯片劃分為多個芯片,僅縮放具有先進技術節點的芯片,并使用 2.5D 或 3D 封裝將它們集成。這提高了產量并降低了成本。
混合鍵合 (HB) 是另一個重要趨勢,可實現金屬-金屬和氧化物-氧化物面對面堆疊,且凸點間距小于 10 μm。它用于 CIS 和 3D NAND 堆疊等應用的晶圓到晶圓混合鍵合,以及用于PC、HPC和數據中心的邏輯上內存堆疊以及3D IC 中的 3D SoC 的持續開發。
與傳統封裝相比,先進封裝需要不同的設備、材料和工藝,例如新的基板材料、光刻工藝、激光鉆孔、CMP 和 KGD 測試。先進封裝參與者進行了大量投資來開發和引入這些進步。與先進封裝的異構集成推動了半導體創新,提高了整體系統性能,同時降低了成本。

頭部玩家“血拼”先進封裝
在這場先進封裝技術競賽中,臺積電占據領先地位。
從技術來看,臺積電重心在發展扇出型封裝 InFO(Integrated Fan Out,整合扇出型封裝)、2.5D 封裝 CoWoS( Chip-on-Wafer-on-Substrate , 基板上晶圓上芯片封裝) 和 3D封 裝 SoIC(System-on-Integrated-Chips,集成芯片系統)。

和臺積電相似,英特爾也在先進封裝領域布局多年,相繼推出 EMIB、Foveros 和 Co-EMIB等先進封裝技術,但相關產品的量產時間均落后于臺積電。
由于臺積電 CoWoS 技術的領先優勢,三星近年來錯失大陸英偉達和蘋果等巨頭的芯片代工訂單,與臺積電的市占率差距不斷擴大。為扭轉公司封裝技術的落后局勢,三星持續發力,相繼推出 I-Cube、H-Cube 和 X-Cube 三大先進封裝技術。

日月光作為目前全球最大的封裝測試廠商,于 2022 年推出了 VIPack 先進封裝平臺,提供垂直互聯整合封裝解決方案。此平臺利用先進的重布線層(RDL)制程、嵌入式整合以及2.5D/3D 封裝技術實現超高密度和性能設計的三維異質封裝結構。
除了臺積電、英特爾、三星和日月光擁有先進封裝技術之外,中國大陸的頭部廠商在先進封裝的開發上也并不落后。例如全球第三、中國大陸第一的封測廠長電科技,已經開發了2.5D/3D封裝、晶圓級封裝(WLP)、堆疊封裝(PoP)等先進封裝技術,覆蓋面可追平日月光。全球第五、中國大陸第二的通富微電,除了掌握2.5D/3D封裝等技術外,還在收購了AMD兩大封測廠后與其深度綁定,后者是目前先進封裝的最大客戶之一。
先進封裝的出現,讓業界看到了通過封裝技術推動芯片高密度集成、性能提升、體積微型化和成本下降的巨大潛力,目前,人工智能(AI)、高性能計算、數據中心、自動駕駛汽車、5G都有先進封裝的身影,應用領域逐漸擴大,各大廠商摩拳擦掌地為AI浪潮積極地做準備,一場先進封裝技術競賽已然拉開了帷幕。
說明:本文素材來自于半導體產業縱橫及網絡公開信息



