在半導(dǎo)體行業(yè)持續(xù)追求更高性能、更低功耗和更小尺寸的今天,先進(jìn)封裝技術(shù)已成為推動(dòng)芯片發(fā)展的重要引擎。CoWoP、CoWoS和CoPoS作為三種主流的2.5D/3D封裝技術(shù),經(jīng)常被業(yè)內(nèi)人士提及,但它們的區(qū)別和應(yīng)用場(chǎng)景卻讓許多人感到困惑。本文將為您詳細(xì)解析這三種技術(shù)的異同點(diǎn)。
當(dāng)前霸主:CoWoS技術(shù)的輝煌與局
CoWoS (Chip on Wafer on Substrate)
CoWoS作為臺(tái)積電主導(dǎo)的先進(jìn)封裝技術(shù),已成為AI時(shí)代不可或缺的基礎(chǔ)設(shè)施。這項(xiàng)技術(shù)通過(guò)在硅晶圓片上安裝裸芯片并與硅中介層結(jié)合,再封裝于有機(jī)基板上,實(shí)現(xiàn)了處理器、加速器與高帶寬存儲(chǔ)(HBM)的高密度集成。技術(shù)原理上,CoWoS采用四層結(jié)構(gòu):硅芯片+中介層+有機(jī)封裝基板+PCB主板。微凸點(diǎn)倒裝技術(shù)將芯片與硅中介層相連,再通過(guò)封裝基板與主板對(duì)接。這種設(shè)計(jì)顯著縮短了芯片間距離,提升了帶寬和能效,使英偉達(dá)A100/H100等AI加速器性能得以充分發(fā)揮。
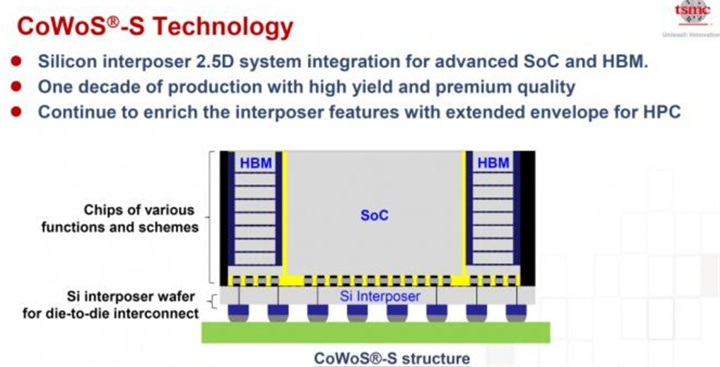
CoWoS已演進(jìn)多代,包括:
CoWoS-S:標(biāo)準(zhǔn)硅中介層版本
CoWoS-R:采用重布線層(RDL)替代部分硅中介
CoWoS-L:結(jié)合局部硅互聯(lián)與RDL,成為當(dāng)前主流
然而,CoWoS面臨三大瓶頸:
圓形晶圓利用率僅約85%,邊緣區(qū)域浪費(fèi)嚴(yán)重。
硅中介層和ABF基板成本居高不下。
隨著芯片功率密度提升,散熱和信號(hào)傳輸接近物理極限。

盡管臺(tái)積電計(jì)劃2026年將CoWoS月產(chǎn)能提升至9-11萬(wàn)片,但市場(chǎng)需求仍遠(yuǎn)超供應(yīng)能力,亞馬遜、微軟等巨頭的訂單已排至數(shù)年之后。這種"甜蜜的煩惱"正加速下一代封裝技術(shù)的誕生。
革命性突破:CoPoS技術(shù)面板化革新導(dǎo)讀
在臺(tái)積電的技術(shù)藍(lán)圖中,CoPoS(Chip-on-Panel-on-Substrate)被視為CoWoS的接班人。這一技術(shù)將圓形晶圓變?yōu)榉叫蚊姘澹镁匦位逄娲鷤鹘y(tǒng)硅中介層,實(shí)現(xiàn)了一場(chǎng)"以方代圓"的封裝革命。
核心創(chuàng)新點(diǎn)在于:
1、基板形態(tài):采用310×310mm至750×620mm的方形面板,面積利用率超95%。
2、材料革新:以玻璃/藍(lán)寶石中介層替代硅,提升熱穩(wěn)定性和成本效益。
3、工藝優(yōu)化:支持更大光罩,單次封裝更多芯片。
4、與類(lèi)似技術(shù)FOPLP相比,CoPoS保留了中介層結(jié)構(gòu),在信號(hào)完整性和功率傳輸上更勝一籌,特別適合集成GPU和HBM的高端產(chǎn)品。
量產(chǎn)路線圖已明確:
2026年:首條實(shí)驗(yàn)線在臺(tái)積電嘉義AP7廠設(shè)立。
2028-2029年:實(shí)現(xiàn)量產(chǎn),逐步取代CoWoS-L15。
行業(yè)分析指出,CoPoS可將單位面積成本降低20-30%,為AI芯片的大規(guī)模普及提供可能。這種"更大、更省、更高效"的技術(shù)路線,正吸引英偉達(dá)等巨頭密切關(guān)注。
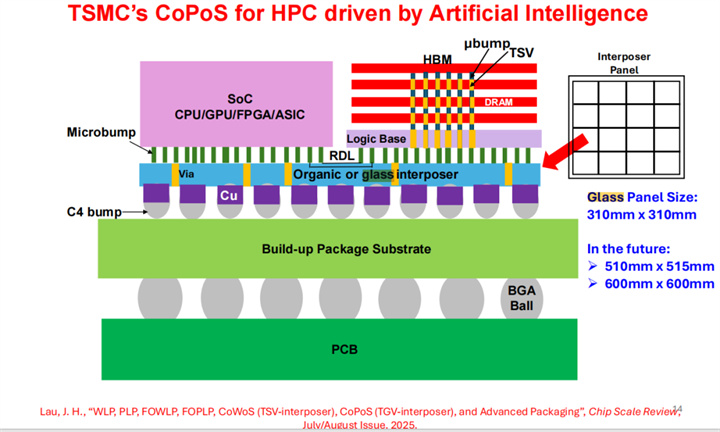
顛覆性構(gòu)想:CoWoP技術(shù)的成本革命
技術(shù)優(yōu)勢(shì)顯而易見(jiàn):
1、成本降低30-50%:去除占成本40%的封裝基板。
2、信號(hào)路徑更短:減少傳統(tǒng)封裝中信號(hào)經(jīng)基板到主板的損耗。
3、散熱更高效:無(wú)蓋設(shè)計(jì)使散熱器直觸芯片。
然而,技術(shù)挑戰(zhàn)同樣巨大:
1、PCB需具備亞10μm線寬/間距的布線能力,遠(yuǎn)超當(dāng)前HDI PCB的20-35μm水平。
2、大尺寸PCB的平整度和材料匹配問(wèn)題。
3、量產(chǎn)良率控制難題。
業(yè)內(nèi)消息稱,英偉達(dá)已在測(cè)試450×450mm規(guī)格的CoWoP方案,但短期內(nèi)其Rubin旗艦芯片仍將采用傳統(tǒng)ABF基板。這反映出新技術(shù)從概念到量產(chǎn)的重重阻礙。
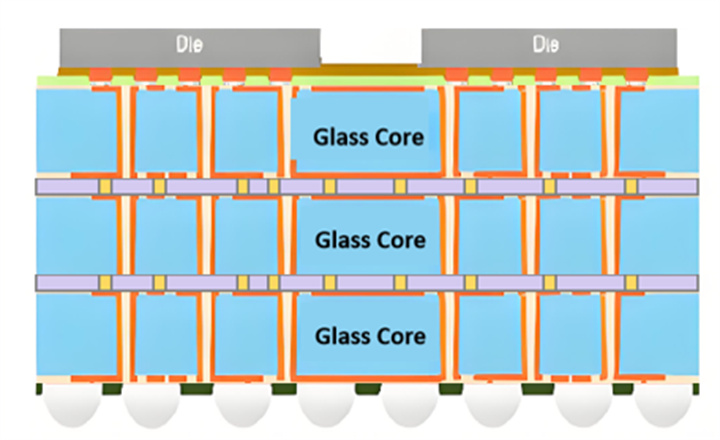
技術(shù)對(duì)比與未來(lái)展望
未來(lái)趨勢(shì)已現(xiàn)端倪:
短期(2-3年):CoWoS仍是主流,CoWoS-L為重點(diǎn)方向。
中期(3-5年):CoPoS逐步量產(chǎn),與CoWoS并行發(fā)展。
長(zhǎng)期(5年以上):CoWoP若突破技術(shù)瓶頸,或重塑封裝生態(tài)。
玻璃基板技術(shù)將成為關(guān)鍵變量,其在熱穩(wěn)定性、信號(hào)損耗和平整度上的優(yōu)勢(shì),可能同時(shí)影響CoPoS和CoWoP的發(fā)展路徑。
結(jié)語(yǔ):技術(shù)演進(jìn)永無(wú)止境
從CoWoS到CoPoS再到CoWoP,半導(dǎo)體封裝技術(shù)正經(jīng)歷從"圓"到"方"、從"多層"到"簡(jiǎn)化"的深刻變革。這場(chǎng)變革不僅是形式的改變,更是芯片系統(tǒng)設(shè)計(jì)范式的轉(zhuǎn)變——將半導(dǎo)體集成邏輯從晶圓級(jí)思維拓展至面板級(jí)維度。
在AI算力需求呈指數(shù)級(jí)增長(zhǎng)的今天,封裝技術(shù)已不再是芯片制造的"后端環(huán)節(jié)",而是決定算力天花板的戰(zhàn)略前沿。無(wú)論最終哪種技術(shù)路線勝出,受益的都將是整個(gè)計(jì)算產(chǎn)業(yè)和終端用戶。正如一位行業(yè)專(zhuān)家所言:"歷史的創(chuàng)造者總是站在前人的肩膀上開(kāi)啟下一個(gè)時(shí)代。"CoWoS奠定了先進(jìn)封裝的基礎(chǔ),而CoPoS和CoWoP則代表著更高效、更經(jīng)濟(jì)的未來(lái)方向。在這場(chǎng)技術(shù)演進(jìn)中,我們期待見(jiàn)證更多"更近、更省、更性感"的創(chuàng)新突破。




